3D Interferometric-Sensors

nXR-1
Spectral interferometer sensor
Nanostructure 3D measurement technology
for multi-layer thin-film devices
for multi-layer thin-film devices
The principle of the spectral interference method is to acquire a spectral interference signal by a dispersing element structure and to acquire line profile information about the surface shape of the multi-layered thin-film structure and the thickness of the multi-layered thin-film at once.
In the case of horizontal resolution, it determines by the objective lens's magnification, so it is possible to measure the surface shape of a multilayer thin film with nanometer-level precision while having a higher horizontal resolution than existing Reflectometry & Ellipsometry.
Key Features
· Real-time multi-layer thin film thickness & surface shape measurement
· Applicable to measurement of multi-layer thin film structures such as semiconductors and displays
· Applicable to measurement of multi-layer thin film structures such as semiconductors and displays
· Applicable to the mass production line
· Fast measuring and data acquisition
· High precision
· Fast measuring and data acquisition
· High precision
· Simple measurement process
· Various data analysis
· Easy user interface
· Various data analysis
· Easy user interface
Application
Measurement Result (Multi-layer films)
3D Thickness Information
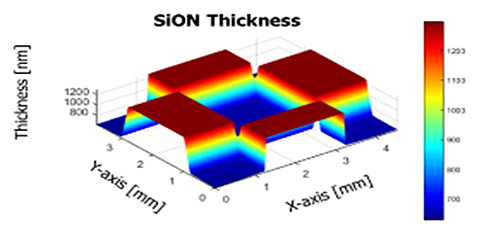
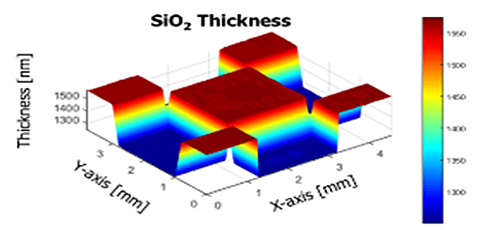
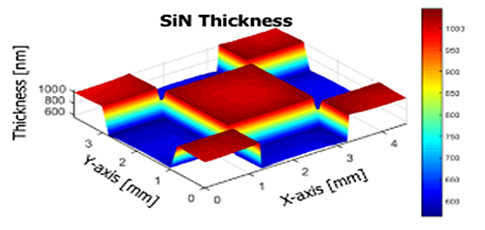
3D Surface Information
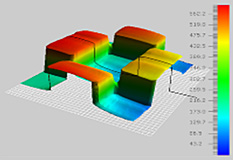
3nd Layer : SiON Layer
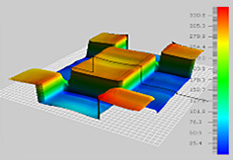
2nd Layer : SiO₂ Layer
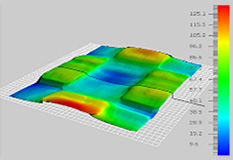
1st Layer : SiN Layer
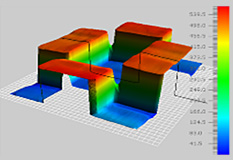
Substrate : Si
3D Thickness Profile
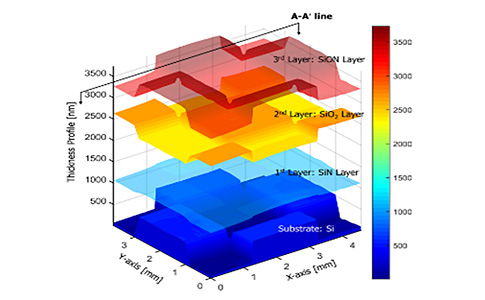
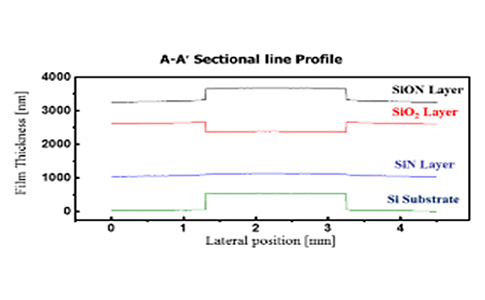
Specifications
Request a specification
Contact us
Latest News
Request a sample test
Request a sample test now!
You can experience the technology of Nexensor.
You can experience the technology of Nexensor.
Contact us
| Measuring model | Measuring technology | Test content | Measuring data |

|
Large-area measurement with WSI interferometers FOV extensive application | Micro Bump Height Monolayer membrane thickness measurement PCB fine pattern Processed surface roughness measurement Sensor step-difference measurement |
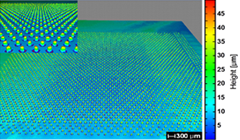
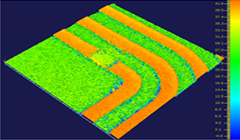

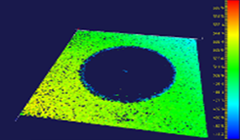

|

|
Free-Form Metrology
Divided inspection possible according to product curve angels
|
Inspection of lens and glass, and measurement of shapes
Inspection of OLED surfaces, and measurement of shapes
Inspection of wafer surfaces, and measurement of shapes
|
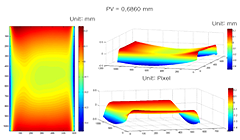



|

|
Real-time measurement of transparent and semitransparent product thickness
Applicable to multi-channels
|
Measurement of wafer(silicone, sapphire) thickness
Measurement of glass and film thickness
|

|



